Электронно дырочный переход и его свойства в полупроводниках
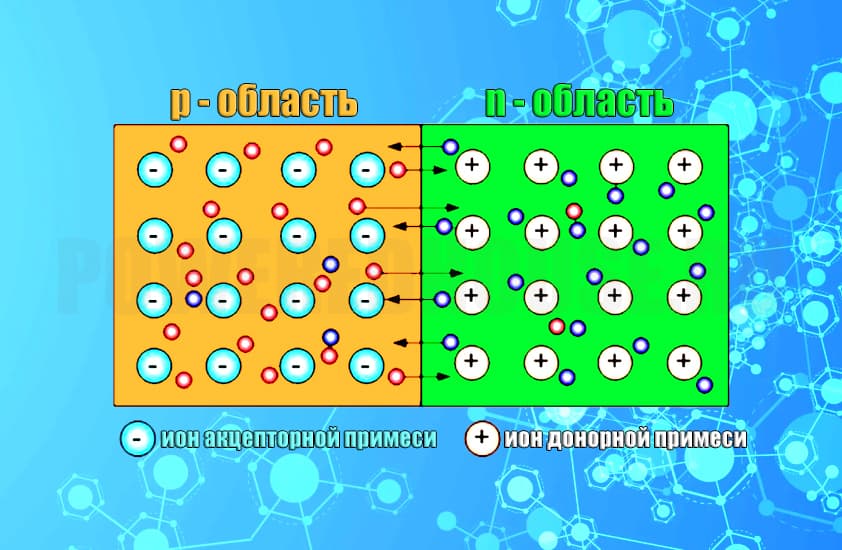
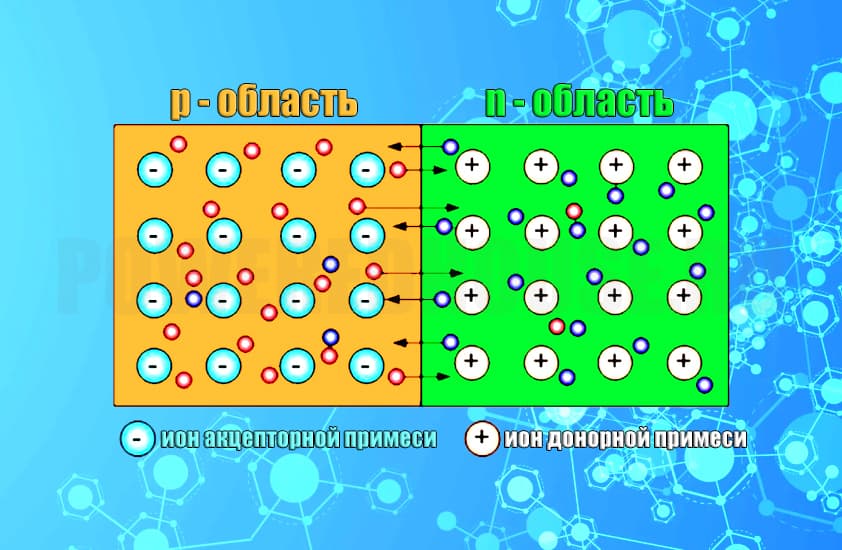
Электронно дырочный переход - это контакт двух примесных полупроводников с различными типами (другое название - p-n-переход). Он создается путем введения в одну часть полупроводникового кристалла донорной примеси, а в другую - акцепторной (легирование).
Донорные примеси приводят к увеличению концентрации свободных электронов в кристалле. Акцепторные примеси приводят к увеличению концентрации дырок. В полупроводнике n типа электроны являются основными носителями заряда, а дырки - неосновными. В полупроводнике p типа дырки являются основными носителями заряда, а электроны - неосновными.
Прежде чем раскрывать вопрос электронно дырочного перехода, важно ознакомится с общими сведениями о полупроводниках.
Полупроводники - основы
Полупроводники - это вещества, удельная проводимость которых имеет промежуточное значение между удельными проводимостями металлов и диэлектриков.
Типичным полупроводником является кремний (Si), в состав атома которого входят 14 электронов. 4 электрона из 14 находятся в незаполненной внешней оболочке и являются слабо связанными (валентные электроны).
Атомы кремния могут объединять валентные электроны с другими атомами кремния с помощью ковалентных связей:
При нулевой температуре в кристалле кремния свободные носители заряда отсутствуют. При повышении температуры происходит разрыв некоторых валентных связей, и электроны, участвующие ранее в создании валентных связей, отщепляются и становятся электронами проводимости. А при наличии электрического поля они перемещаются против поля и образуют электрический ток.
При освобождении электрона в кристаллической решетке образуется незаполненная межатомная связь - дырка. Данный процесс создает дополнительную возможность для переноса заряда - дырка может быть заполнена электроном, перешедшим под действием тепловых колебаний от соседнего атома. В результате в месте, где будет заполнена дырка будет восстановлена нормальная связь, а в другом месте появится другая дырка. Последовательное заполнение свободной связи электронами одновременно сопровождается движением дырки в противоположном движении электронов направлении.
Исходя из вышеописанного можно отметить, что в полупроводнике имеются два типа носителей заряда - электроны и дырки. Общая проводимость полупроводника равна сумме электронной проводимости n-типа и дырочной проводимости p-типа.
Легирование полупроводников
Легирование - добавление примесей для увеличения проводимости чистых полупроводников. При этом применяются два типа примесей:
Полупроводники p и n типов имеют более высокую проводимость, чем чистые полупроводники. Проводимость может быть уменьшена или увеличена путем изменения количества примесей.
Свойства электронно дырочного перехода
Электронно дырочный переход (p-n) создается в пластине полупроводника путем образования в ней области с различными типами проводимости. В области данного перехода имеется значительный перепад концентрации носителей зарядов, когда электронов в n-области больше, чем в p-области. В результате чего происходит:
- Диффузия электронов из n-области в p-область. При этом в n-области остаются неподвижные положительно заряженные ионы доноров.
- Одновременно происходит диффузия дырок из p-области в n-область. За счет отрицательно заряженных ионов акцепторов приграничная p-область приобретает отрицательный заряд.
- Две данных прилегающих области образуют слой объемного заряда, в котором возникает контактное электрическое поле Ek (Epn), препятствующее дальнейшему переходу электронов и дырок.
Контактное поле поддерживает равновесное состояние при определенных условиях. При повышении температуры небольшая часть электронов и дырок преодолевает контактное поле и создает ток диффузии. Одновременно за счет неосновных носителей заряда создается ток проводимости. В состоянии равновесия эти токи взаимно компенсируются.
Рассмотрим более подробно p-n-переход в отсутствие внешнего поля. Вблизи границы перехода образуется двойной заряженный слой. Электрическое поле, созданное этим слоем, направлено по нормали к границе от n к p области. Это поле препятствует процессу диффузии основных носителей и, таким образом, создает для них потенциальный барьер:
 |
На энергетической диаграмме энергия электронов и дырок отсчитывается от их состояния соответственно в n и p областях. |
Поэтому из n в p область могут перейти только те электроны, энергия которых превышает высоту потенциального барьера Фpn. Концентрация электронов, обладающих энергией, достаточной для преодоления барьера, определяется распределением Больцмана:
n = n0 exp (-Фpn ⁄ kT), где: n0 - концентрация электронов в n-области.
Прошедшие за барьер электроны создают электронную компоненту диффузионного тока In. Точно так же дырки, преодолевшие барьер, образуют дырочную компоненту диффузионного тока Ip. Ip и In направлены от p к n области, и суммарный ток основных носителей равен:
I0 = In + Ip ∼ exp (-Фpn ⁄ kT)
Теперь посмотрим энергетическую диаграмму p-n-перехода в отсутствие внешнего поля (предыдущее изображение). Поле вблизи границы способствует движению неосновных носителей, которые "скатываются" с потенциальной "горки". Поэтому все неосновные носители, генерируемые в приконтактной области, движутся через электронно дырочный переход и образуют ток, направленный от n к p. Сила этого тока насыщения практически не зависит от разности потенциалов между n и p полупроводниками и определяется только числом неосновных носителей, образующихся в приконтактной области в единицу времени: Is = Ins + Ips.
В состоянии равновесия устанавливается такая высота потенциального барьера, при которой полный ток равен нулю I = I0 - Is = 0.
Приложение напряжения к диоду с p-n переходом
Полупроводниковый диод - это пластина полупроводника (кремний или германий), одна сторона которой с электропроводностью р-типа, а другая с проводимость n-типа. На внешние поверхности пластины диода нанесены контактные металлические слои, к которым припаяны проволочные выводы электродов.
Приложим к диоду, содержащему p-n переход, напряжение (смещение U от внешнего источника). В этом случае если анод источника «+» соединен с p-областью диода, а катод источника «-» с n-областью, то речь идет о прямом смещении (U > 0). В противоположном случае - это обратное смещение (U < 0).
В электрической цепи с внешним источником диод содержит три соединенных последовательно области: p-область, объемный заряд (барьер), n-область. Так как потенциальный барьер препятствует движению основных носителей, и притом их средняя тепловая энергия kT << Фpn, область объемного заряда практически полностью обеднена свободными носителями тока (электронами и дырками). Данная область обладает наибольшим электрическим сопротивлением и практически все приложенное напряжение U в ней падает.
Рассмотрим случай прямого (а) и обратного (б) смещения:
При прямом смещении (а) поле от внешнего источника направлено навстречу полю, создаваемому объемным зарядом. Следовательно, напряжение U вычитается из барьерной разности потенциалов Upn = Фpn ⁄ e, существовавшей до приложения внешнего смещения. В результате разность потенциалов на барьере становится равной (Upn - U), а высота энергетического барьера:
e(Upn - U) = Фpn - eU.
Уменьшение высоты энергетического барьера приводит к увеличению концентрации основных носителей, преодолевающих барьер. Концентрация электронов за барьером теперь равна: n1 = n0 exp[-(-Фpn - eU ⁄ kT)] и увеличилась в n1 ⁄ n = exp(eU ⁄ kT) раз. Во столько же раз увеличится и создаваемый ими электронный диффузионный ток:
In1 = exp(eU ⁄ kT).
На ток неосновных носителей (ток насыщения) прямое смещение (так же как и обратное) влияния не оказывает. Ток электронов из p-области в n-область по-прежнему равен Ins и течет навстречу диффузионному току.
Таким образом, электронная компонента прямого тока In будет равна:
In = In1 - Ins = Ins[exp(eU ⁄ kT) - 1].
Дырочная компонента прямого тока:
Ip = Ip1 - Ips[exp(eU ⁄ kT) - 1].
Полный ток через p-n переход равен сумме электронной и дырочной компонент:
I = In - Ip = (Ins + Ips)[exp(eU ⁄ kT) - 1] = Is[exp(eU ⁄ kT) - 1].
При обратном смещении (б) происходит увеличение высоты потенциального барьера. Так как при этом принято предложенное напряжение U считать отрицательным, то соотношение e(Upn - U) = Фpn - eU остается в силе, так же как и последующие рассуждения. Поэтому формула I = Is[exp(eU ⁄ kT) - 1]
описывает не только прямую, но и обратную ветви вольт амперную-характеристику диода (ВАХ).
Вольт-амперная характеристика полупроводникового диода:
Штрихпунктирной линией показана кривая,
соответствующая теоретической зависимости I = Is[exp(eU ⁄ kT) - 1], сплошной линией - экспериментальная ВАХ.
Продолжение линейного участка ВАХ до пересечения с осью U дает значение напряжения отсечки Uотс, которое можно принять за оценку барьерной разности потенциалов Upn ≈ Uотс. Значение Upn совпадает с числовым значением высоты потенциального барьера Фpn, выраженном в электрон-вольтах.
Обратная ветвь ВАХ также отличается от теоретической Iобр = Is для IUI >> kT. В этой области сопротивление электронно дырочного перехода быстро увеличивается и даже превышает сопротивление изоляции диода. Поэтому возникает ток утечки, который течет не через p-n переход, а через постоянное сопротивление изоляции. Этой ситуации соответствует линейный участок обратной ветви, пересечение которого с осью тока I дает оценку тока насыщения Is.
Для оценки ширины электронно дырочного перехода можно использовать формулу: d ≈ √((2εε0Uотс) ⁄ end), где nd - концентрация атомов донорной примеси в полупроводнике n-типа, ε - диэлектрическая проницаемость материала полупроводника.